
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
SiGe in Chip Manufacturing: A Professional News Report
Η Εξέλιξη των Ημιαγωγών Υλικών
Στη σφαίρα της σύγχρονης τεχνολογίας ημιαγωγών, η αδιάκοπη προσπάθεια προς τη σμίκρυνση έχει ωθήσει τα όρια των παραδοσιακών υλικών με βάση το πυρίτιο. Για να ανταποκριθεί στις απαιτήσεις για υψηλές επιδόσεις και χαμηλή κατανάλωση ενέργειας, το SiGe (Silicon Germanium) έχει αναδειχθεί ως σύνθετο υλικό επιλογής στην κατασκευή τσιπ ημιαγωγών λόγω των μοναδικών φυσικών και ηλεκτρικών ιδιοτήτων του. Αυτό το άρθρο εμβαθύνει στοδιαδικασία της επιταξίαςτου SiGe και του ρόλου του στην επιταξιακή ανάπτυξη, τις εφαρμογές τεταμένου πυριτίου και τις δομές Gate-All-Around (GAA).
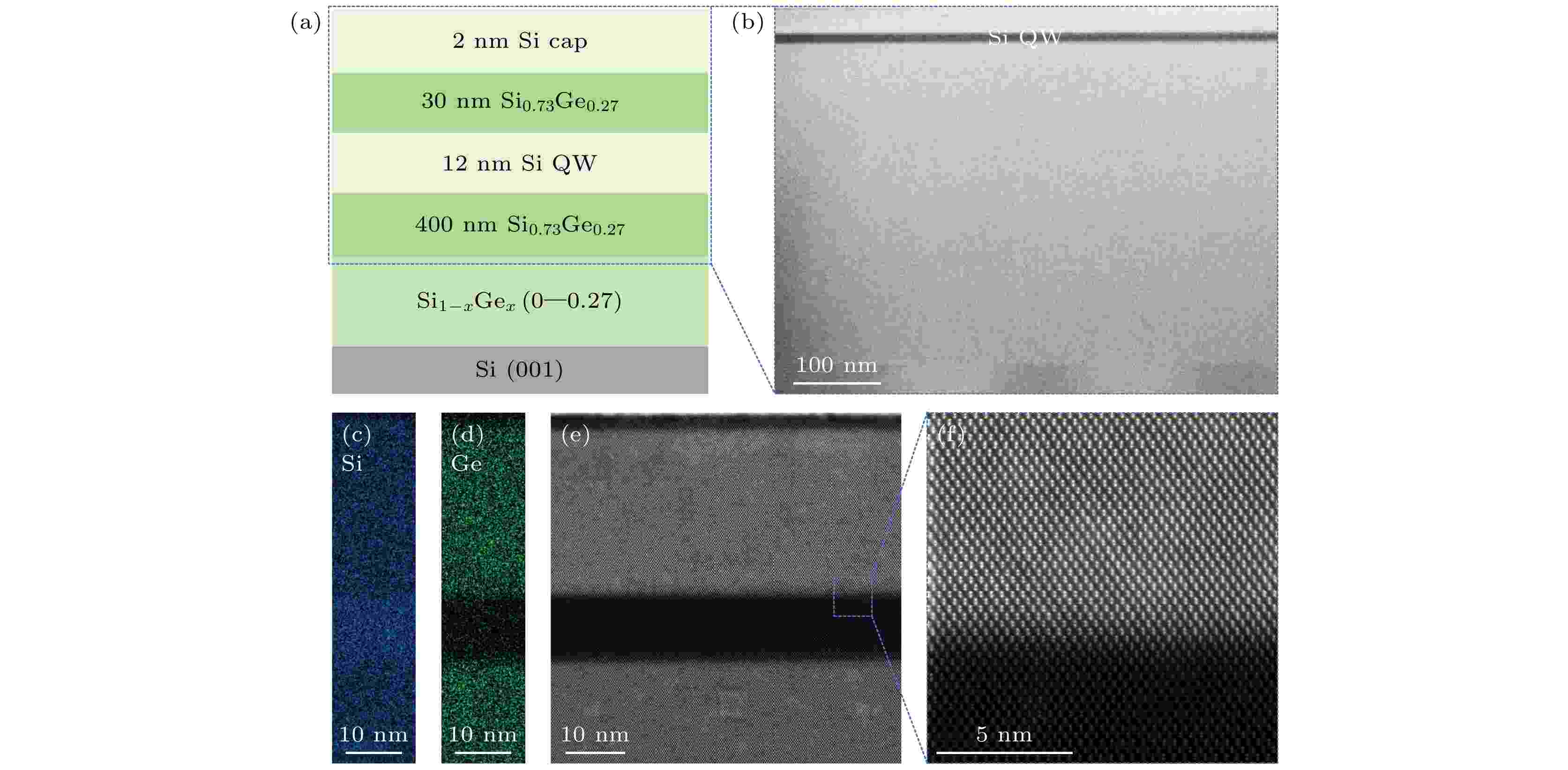
Η σημασία της επιτάξεως SiGe
1.1 Εισαγωγή στο Epitaxy στην Κατασκευή Chip:
Η επιταξία, που συχνά συντομεύεται ως Epi, αναφέρεται στην ανάπτυξη ενός μονοκρυσταλλικού στρώματος σε ένα μονοκρυσταλλικό υπόστρωμα με την ίδια διάταξη πλέγματος. Αυτό το στρώμα μπορεί να είναι είτεομοεπιταξιακή (όπως Si/Si)ή ετεροεπιταξιακή (όπως SiGe/Si ή SiC/Si). Διάφορες μέθοδοι χρησιμοποιούνται για την επιταξιακή ανάπτυξη, συμπεριλαμβανομένων της Επιτάξεως Μοριακής Δέσμης (MBE), της Εναπόθεσης Χημικών Ατμών Υπερυψηλού Κενού (UHV/CVD), της Ατμοσφαιρικής και της Επιταξίας μειωμένης Πίεσης (ATM & RP Epi). Αυτό το άρθρο εστιάζει στις διεργασίες επιταξίας του πυριτίου (Si) και του πυριτίου-γερμανίου (SiGe) που χρησιμοποιούνται ευρέως στην παραγωγή ολοκληρωμένων κυκλωμάτων ημιαγωγών με το πυρίτιο ως υλικό υποστρώματος.
1.2 Πλεονεκτήματα του SiGe Epitaxy:
Ενσωματώνοντας μια ορισμένη αναλογία γερμανίου (Ge) κατά τη διάρκεια τουδιαδικασία της επιταξίαςσχηματίζει ένα μονοκρυσταλλικό στρώμα SiGe που όχι μόνο μειώνει το πλάτος του διακενού ζώνης αλλά αυξάνει επίσης τη συχνότητα αποκοπής του τρανζίστορ (fT). Αυτό το καθιστά ευρέως εφαρμόσιμο σε συσκευές υψηλής συχνότητας για ασύρματες και οπτικές επικοινωνίες. Επιπλέον, σε προηγμένες διεργασίες ολοκληρωμένων κυκλωμάτων CMOS, η αναντιστοιχία πλέγματος (περίπου 4%) μεταξύ Ge και Si εισάγει τάση πλέγματος, ενισχύοντας την κινητικότητα ηλεκτρονίων ή οπών και αυξάνοντας έτσι το ρεύμα κορεσμού και την ταχύτητα απόκρισης της συσκευής.
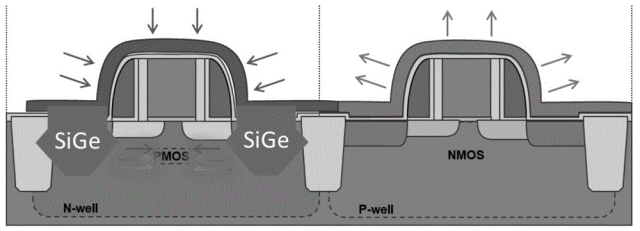
Η Ολοκληρωμένη Ροή Διαδικασίας Επιταξίας SiGe
2.1 Προθεραπεία:
Οι γκοφρέτες πυριτίου υποβάλλονται σε προεπεξεργασία με βάση τα επιθυμητά αποτελέσματα της διαδικασίας, που περιλαμβάνουν κυρίως την αφαίρεση του φυσικού στρώματος οξειδίου και των ακαθαρσιών στην επιφάνεια του πλακιδίου. Για γκοφρέτες υποστρώματος με έντονη ντόπινγκ, είναι σημαντικό να εξεταστεί εάν η οπίσθια σφράγιση είναι απαραίτητη για τη μείωση του αυτόματου ντόπινγκ κατά τη διάρκεια των επόμενωνepitaxy growth.
2.2 Αέρια και συνθήκες ανάπτυξης:
Αέρια πυριτίου: το σιλάνιο (SiH4), το διχλωροσιλάνιο (DCS, SiH2Cl2) και το τριχλωροσιλάνιο (TCS, SiHCl3) είναι οι τρεις πιο συχνά χρησιμοποιούμενες πηγές αερίου πυριτίου. Το SiH4 είναι κατάλληλο για διεργασίες πλήρους επιταξίας σε χαμηλή θερμοκρασία, ενώ το TCS, γνωστό για τον γρήγορο ρυθμό ανάπτυξής του, χρησιμοποιείται ευρέως για την παρασκευή παχύρρευστωνεπιταξία πυριτίουστρώματα.
Αέριο γερμάνιο: Το Γερμανικό (GeH4) είναι η κύρια πηγή για την προσθήκη γερμανίου, που χρησιμοποιείται σε συνδυασμό με πηγές πυριτίου για το σχηματισμό κραμάτων SiGe.
Επιλεκτική επιταξία: Η επιλεκτική ανάπτυξη επιτυγχάνεται με την προσαρμογή των σχετικών ρυθμών τουεπιταξιακή εναπόθεσηκαι in situ χάραξη, χρησιμοποιώντας αέριο πυρίτιο που περιέχει χλώριο DCS. Η επιλεκτικότητα οφείλεται στο ότι η προσρόφηση των ατόμων Cl στην επιφάνεια του πυριτίου είναι μικρότερη από αυτή στα οξείδια ή τα νιτρίδια, διευκολύνοντας την επιταξιακή ανάπτυξη. Το SiH4, χωρίς άτομα Cl και με χαμηλή ενέργεια ενεργοποίησης, εφαρμόζεται γενικά μόνο σε διαδικασίες πλήρους επιταξίας χαμηλής θερμοκρασίας. Μια άλλη ευρέως χρησιμοποιούμενη πηγή πυριτίου, το TCS, έχει χαμηλή πίεση ατμών και είναι υγρό σε θερμοκρασία δωματίου, απαιτώντας φυσαλίδες Η2 για να εισαχθεί στον θάλαμο αντίδρασης. Ωστόσο, είναι σχετικά φθηνό και χρησιμοποιείται συχνά για τον γρήγορο ρυθμό ανάπτυξής του (έως 5 μm/min) για την ανάπτυξη παχύτερων στρωμάτων επιταξίας πυριτίου, που εφαρμόζονται ευρέως στην παραγωγή γκοφρέτας επιταξίας πυριτίου.
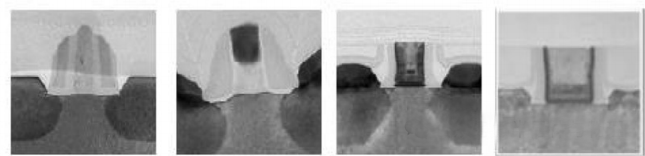
Στραγμένο πυρίτιο σε επιταξιακές στρώσεις
Κατά την διάρκειαεπιταξιακή ανάπτυξη, επιταξιακό μονοκρυσταλλικό Si εναποτίθεται σε χαλαρό στρώμα SiGe. Λόγω της αναντιστοιχίας πλέγματος μεταξύ Si και SiGe, το μονοκρυσταλλικό στρώμα Si υπόκειται σε τάση εφελκυσμού από το υποκείμενο στρώμα SiGe, ενισχύοντας σημαντικά την κινητικότητα των ηλεκτρονίων στα τρανζίστορ NMOS. Αυτή η τεχνολογία όχι μόνο αυξάνει το ρεύμα κορεσμού (Idsat), αλλά βελτιώνει και την ταχύτητα απόκρισης της συσκευής. Για συσκευές PMOS, τα στρώματα SiGe αναπτύσσονται επιταξιακά στις περιοχές πηγής και αποστράγγισης μετά τη χάραξη για να εισαχθεί συμπιεστική τάση στο κανάλι, ενισχύοντας την κινητικότητα της οπής και αυξάνοντας το ρεύμα κορεσμού.
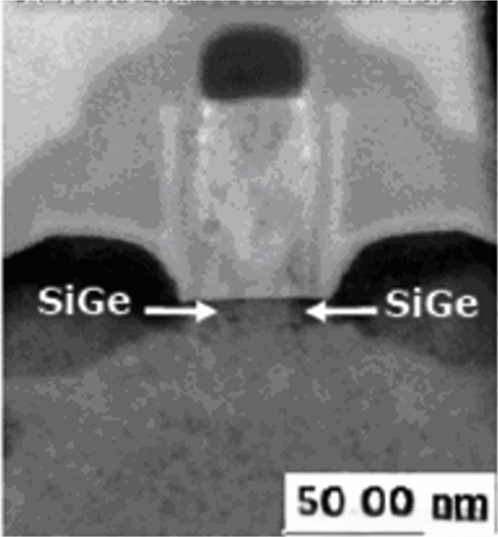
Το SiGe ως στρώμα θυσίας σε δομές GAA
Στην κατασκευή τρανζίστορ νανοσύρματος Gate-All-Around (GAA), τα στρώματα SiGe λειτουργούν ως στρώματα θυσίας. Τεχνικές ανισότροπης χάραξης υψηλής επιλεκτικότητας, όπως η χάραξη οιονεί ατομικής στιβάδας (quasi-ALE), επιτρέπουν την ακριβή αφαίρεση των στρωμάτων SiGe για να σχηματιστούν δομές νανοσύρματος ή νανοφύλλων.
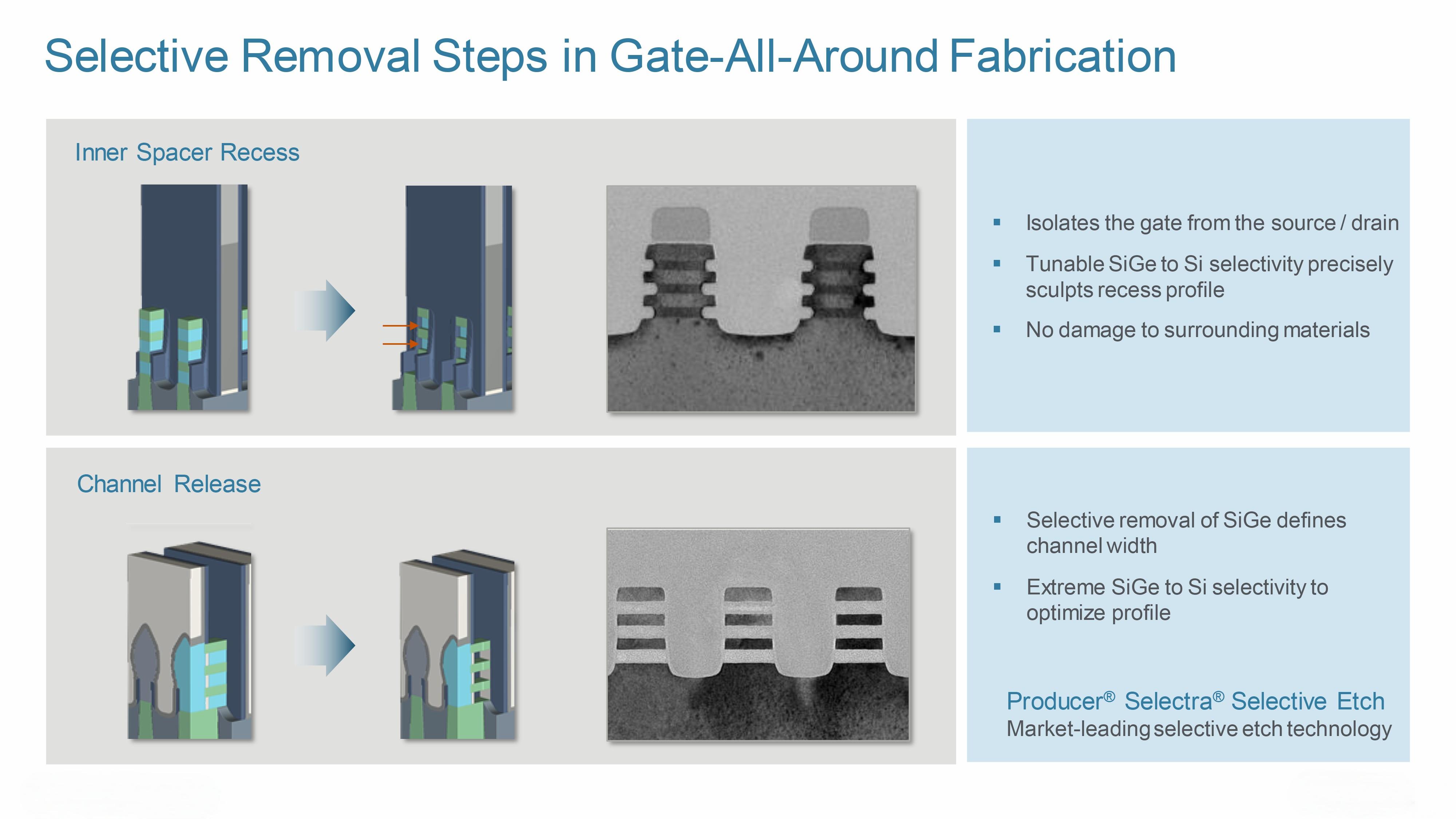
Εμείς στη Semicorex ειδικευόμαστε σεΔιαλύματα γραφίτη επικαλυμμένα με SiC/TaCεφαρμόζεται στην επιταξιακή ανάπτυξη Si στην κατασκευή ημιαγωγών, εάν έχετε οποιεσδήποτε ερωτήσεις ή χρειάζεστε πρόσθετες λεπτομέρειες, μη διστάσετε να επικοινωνήσετε μαζί μας.
Τηλέφωνο επικοινωνίας: +86-13567891907
Email: sales@semicorex.com




